Uvod v silicijev karbid
Silicijev karbid (SiC) je sestavljen polprevodniški material, sestavljen iz ogljika in silicija, ki je eden idealnih materialov za izdelavo visokotemperaturnih, visokofrekvenčnih, visokozmogljivih in visokonapetostnih naprav. V primerjavi s tradicionalnim silicijevim materialom (Si) je pasovna vrzel silicijevega karbida 3-krat večja od silicijeve. Toplotna prevodnost je 4-5-krat večja od silicijeve; prebojna napetost je 8-10-krat večja od silicijeve; stopnja elektronskega nasičenja je 2-3-krat večja od silicijeve, kar zadovoljuje potrebe sodobne industrije po visoki moči, visoki napetosti in visoki frekvenci. Uporablja se predvsem za proizvodnjo visokohitrostnih, visokofrekvenčnih, visokozmogljivih in svetlečih elektronskih komponent. Področja uporabe na nižji ravni vključujejo pametna omrežja, vozila z novo energijo, fotovoltaiko vetrne elektrarne, 5G komunikacijo itd. Komercialno se uporabljajo silicijeve karbidne diode in MOSFET-i.

Odpornost na visoke temperature. Širina pasovne reže silicijevega karbida je 2-3-krat večja od širine silicija, elektroni pri visokih temperaturah ne prehajajo zlahka in lahko prenesejo višje obratovalne temperature, toplotna prevodnost silicijevega karbida pa je 4-5-krat večja od silicija, zaradi česar je odvajanje toplote naprave lažje in mejna obratovalna temperatura višja. Odpornost na visoke temperature lahko znatno poveča gostoto moči, hkrati pa zmanjša zahteve glede hladilnega sistema, zaradi česar je terminal lažji in manjši.
Odpornost na visok tlak. Prebojna jakost električnega polja silicijevega karbida je 10-krat večja od silicija, ki lahko prenese višje napetosti in je bolj primeren za visokonapetostne naprave.
Visokofrekvenčna upornost. Silicijev karbid ima dvakrat večjo hitrost odnašanja elektronov kot silicijev, kar povzroči odsotnost tokovnega repa med postopkom izklopa, kar lahko učinkovito izboljša preklopno frekvenco naprave in doseže miniaturizacijo naprave.
Nizka izguba energije. V primerjavi s silicijevim materialom ima silicijev karbid zelo nizko upornost vklopa in nizke izgube vklopa. Hkrati velika širina pasovne reže silicijevega karbida močno zmanjša uhajalni tok in izgubo moči. Poleg tega silicijev karbidna naprava med izklopom nima pojava zaostajanja toka, izguba pri preklopu pa je nizka.
Industrijska veriga silicijevega karbida
Vključuje predvsem substrat, epitaksijo, načrtovanje naprav, izdelavo, tesnjenje in tako naprej. Silicijev karbid bo od materiala do polprevodniške napajalne naprave podvržen rasti monokristalov, rezanju ingotov, epitaksialni rasti, načrtovanju rezin, izdelavi, pakiranju in drugim postopkom. Po sintezi prahu silicijevega karbida se najprej izdela ingot silicijevega karbida, nato pa se z rezanjem, brušenjem in poliranjem dobi substrat silicijevega karbida, epitaksialna plošča pa se dobi z epitaksialno rastjo. Epitaksialna rezina je izdelana iz silicijevega karbida z litografijo, jedkanjem, ionsko implantacijo, pasivizacijo kovin in drugimi postopki, rezina se razreže v matrico, naprava se zapakira, nato pa se naprava združi v posebno lupino in sestavi v modul.
Gorvodno v industrijski verigi 1: rast substrata in kristalov je osrednja procesna povezava
Silicijev karbidni substrat predstavlja približno 47 % stroškov silicijevega karbidnega substrata, kar je najvišja tehnična ovira pri proizvodnji in največja vrednost, jedro prihodnje obsežne industrializacije SiC.
Z vidika razlik v elektrokemijskih lastnostih lahko materiale silicijevega karbida razdelimo na prevodne substrate (območje upornosti 15~30 mΩ·cm) in pol-izolirane substrate (upornost višja od 105 Ω·cm). Ti dve vrsti substratov se po epitaksialni rasti uporabljata za izdelavo diskretnih naprav, kot so napajalne naprave oziroma radiofrekvenčne naprave. Med njimi se pol-izolirani silicijev karbidni substrat uporablja predvsem pri izdelavi radiofrekvenčnih naprav iz galijevega nitrida, fotoelektričnih naprav in tako naprej. Z gojenjem epitaksialne plasti gan na pol-izoliranem SIC substratu se pripravi epitaksialna plošča sic, ki jo je mogoče nadalje predelati v HEMT gan izo-nitridne radiofrekvenčne naprave. Prevodni silicijev karbidni substrat se uporablja predvsem pri izdelavi napajalnih naprav. Za razliko od tradicionalnega postopka izdelave silicijevih napajalnih naprav silicijevega karbida ni mogoče izdelati neposredno na silicijevem karbidnem substratu, temveč je treba epitaksialno plast silicijevega karbida gojiti na prevodnem substratu, da dobimo silicijev karbidno epitaksialno ploščo, epitaksialna plast pa se izdeluje na Schottkyjevi diodi, MOSFET-u, IGBT-ju in drugih napajalnih napravah.
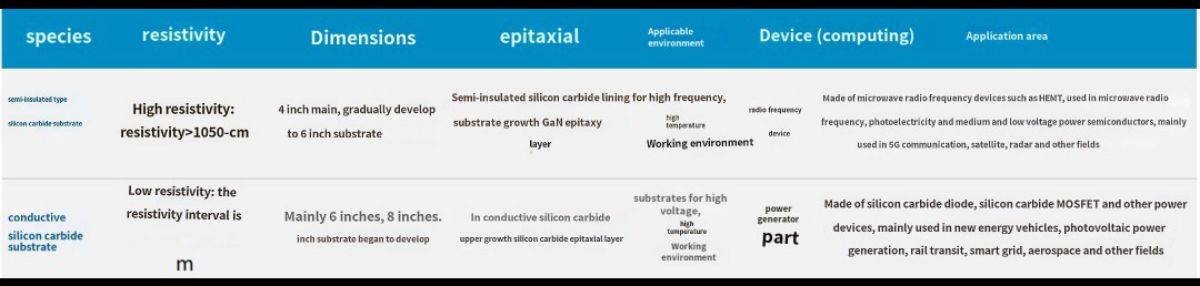
Prah silicijevega karbida je bil sintetiziran iz visoko čistega ogljikovega prahu in visoko čistega silicijevega prahu, različne velikosti ingotov silicijevega karbida pa so bile vzgojene v posebnem temperaturnem polju, nato pa je bil s pomočjo več procesov obdelave izdelan substrat silicijevega karbida. Osnovni postopek vključuje:
Sinteza surovin: Visoko čist silicijev prah in toner se zmešata po formuli in reakcija se izvede v reakcijski komori pri visoki temperaturi nad 2000 °C, da se sintetizirajo delci silicijevega karbida s specifično vrsto kristalov in velikostjo delcev. Nato se z drobljenjem, presejanjem, čiščenjem in drugimi postopki izpolnijo zahteve za visoko čiste surovine iz silicijevega karbidnega prahu.
Rast kristalov je osrednji postopek izdelave substrata silicijevega karbida, ki določa električne lastnosti substrata silicijevega karbida. Trenutno so glavne metode za rast kristalov fizični prenos pare (PVT), visokotemperaturno kemično nanašanje pare (HT-CVD) in epitaksija v tekoči fazi (LPE). Med njimi je metoda PVT trenutno glavna metoda za komercialno rast substrata SiC, z najvišjo tehnično zrelostjo in najpogosteje uporabljeno v inženirstvu.

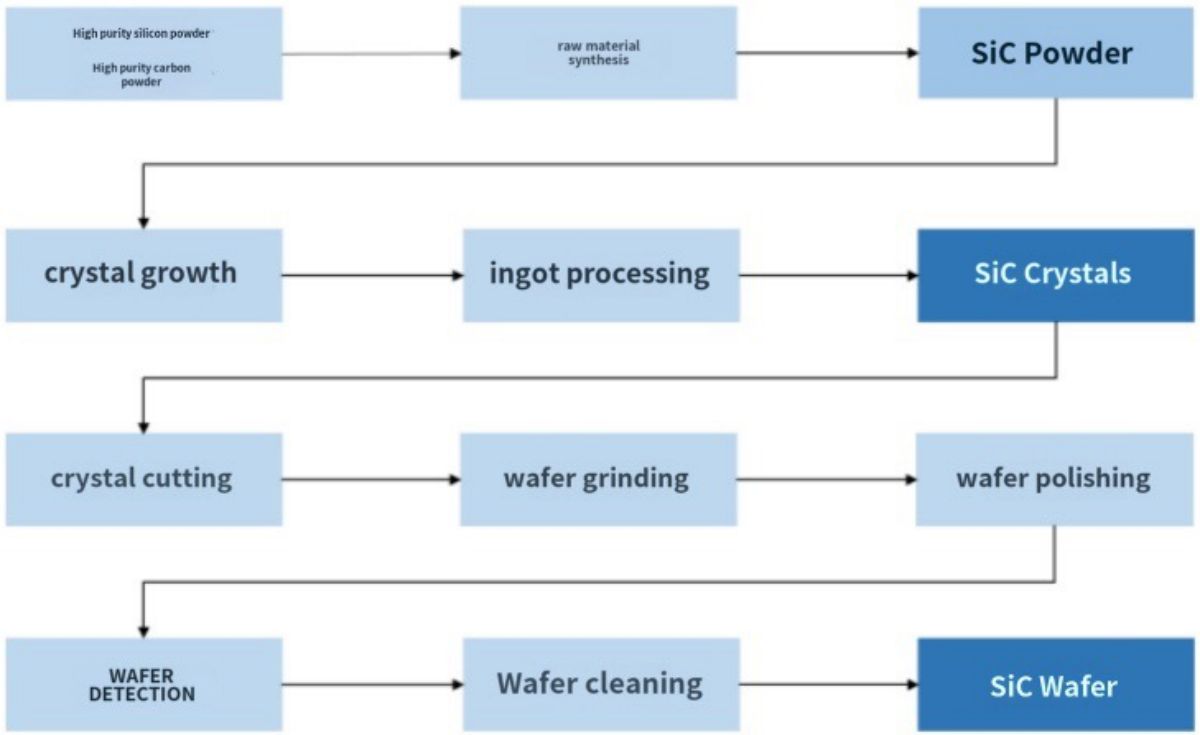
Priprava SiC substrata je težavna, kar vodi v njegovo visoko ceno.
Nadzor temperaturnega polja je težaven: za rast kristalnih palic Si je potrebnih le 1500 ℃, medtem ko je treba kristalne palice SiC gojiti pri visoki temperaturi nad 2000 ℃. Obstaja več kot 250 izomerov SiC, vendar bo glavna monokristalna struktura 4H-SiC za proizvodnjo energetskih naprav, če ni natančnega nadzora, dobila druge kristalne strukture. Poleg tega temperaturni gradient v lončku določa hitrost prenosa sublimacije SiC ter razporeditev in način rasti plinastih atomov na kristalnem vmesniku, kar vpliva na hitrost rasti kristalov in kakovost kristalov, zato je treba oblikovati sistematično tehnologijo nadzora temperaturnega polja. V primerjavi s Si materiali je razlika pri proizvodnji SiC tudi v visokotemperaturnih procesih, kot so visokotemperaturna ionska implantacija, visokotemperaturna oksidacija, visokotemperaturna aktivacija in postopek trde maske, ki ga zahtevajo ti visokotemperaturni procesi.
Počasna rast kristalov: hitrost rasti silicijeve kristalne palice lahko doseže 30 ~ 150 mm/h, proizvodnja 1-3 m silicijeve kristalne palice pa traja le približno 1 dan; na primer, pri silicijevem kristalu, izdelanem s PVT metodo, je hitrost rasti približno 0,2-0,4 mm/h, v 7 dneh pa zraste manj kot 3-6 cm, stopnja rasti pa je manjša od 1 % silicijevega materiala, proizvodna zmogljivost pa je izjemno omejena.
Visoki parametri produkta in nizek izkoristek: osrednji parametri SiC substrata vključujejo gostoto mikrotubulov, gostoto dislokacij, upornost, upogibanje, hrapavost površine itd. Gre za kompleksen sistemski inženiring za razporeditev atomov v zaprti visokotemperaturni komori in dokončanje rasti kristalov, hkrati pa nadzor indeksov parametrov.
Material ima visoko trdoto, visoko krhkost, dolg čas rezanja in visoko obrabo: Mohsova trdota SiC 9,25 je druga po trdoti diamanta, kar znatno poveča težavnost rezanja, brušenja in poliranja, za rezanje 35-40 kosov 3 cm debelega ingota pa je potrebnih približno 120 ur. Poleg tega bo zaradi visoke krhkosti SiC obraba pri obdelavi rezin večja, izhodno razmerje pa bo le približno 60 %.
Trend razvoja: Povečanje velikosti + znižanje cene
Svetovni trg 6-palčnih SiC proizvodnih linij se razvija, vodilna podjetja pa so vstopila na trg 8-palčnih rezin. Domači razvojni projekti so večinoma 6-palčni. Čeprav večina domačih podjetij še vedno temelji na 4-palčnih proizvodnih linijah, se industrija postopoma širi na 6-palčne rezine. Z zrelostjo tehnologije podporne opreme za 6-palčne rezine se postopoma izboljšuje tudi domača tehnologija SiC substratov, kar se odraža v ekonomiji obsega velikih proizvodnih linij, trenutni časovni razmik med domačo 6-palčno masovno proizvodnjo pa se je zmanjšal na 7 let. Večja velikost rezin lahko poveča število posameznih čipov, izboljša stopnjo izkoristka in zmanjša delež robnih rezin, stroški raziskav in razvoja ter izguba izkoristka pa se bodo ohranili na približno 7 %, s čimer se bo izboljšala izkoriščenost rezin.
Pri načrtovanju naprav je še vedno veliko težav
Komercializacija SiC diod se postopoma izboljšuje, trenutno so številni domači proizvajalci zasnovali izdelke SiC SBD. Srednje- in visokonapetostni SiC SBD izdelki imajo dobro stabilnost. V vozilih z uporabo SiC SBD+SI IGBT dosežemo stabilno gostoto toka. Trenutno na Kitajskem ni ovir za patentno zasnovo izdelkov SiC SBD, razlika v primerjavi s tujino pa je majhna.
SiC MOS se še vedno sooča s številnimi težavami, med SiC MOS in tujimi proizvajalci še vedno obstaja vrzel, ustrezna proizvodna platforma pa je še vedno v izgradnji. Trenutno so ST, Infineon, Rohm in drugi 600-1700V SiC MOS dosegli množično proizvodnjo ter podpisali in dobavili pogodbe s številnimi predelovalnimi industrijami, medtem ko je trenutna domača zasnova SiC MOS v osnovi dokončana, številni proizvajalci zasnov sodelujejo s tovarnami v fazi pretoka rezin, kasnejše preverjanje s strani strank pa še vedno traja nekaj časa, zato je do obsežne komercializacije še dolgo.
Trenutno je planarna struktura glavna izbira, v prihodnosti pa se bo v visokotlačnem področju pogosto uporabljal jarkovni tip. Proizvajalci SiC MOS tranzistorjev z planarno strukturo so številni, zato planarna struktura v primerjavi z utorno strukturo ne povzroča lokalnih težav pri preboju, kar bi vplivalo na stabilnost delovanja. Na trgu pod 1200 V ima širok spekter uporabne vrednosti, planarna struktura pa je relativno preprosta v proizvodnji, kar ustreza dvema vidikoma: izdelavi in nadzoru stroškov. Utorna naprava ima prednosti izjemno nizke parazitske induktivnosti, hitre preklopne hitrosti, nizkih izgub in relativno visoke zmogljivosti.
2--Novice o SiC rezinah
Rast proizvodnje in prodaje na trgu silicijevega karbida, bodite pozorni na strukturno neravnovesje med ponudbo in povpraševanjem


Z naraščajočim povpraševanjem na trgu po visokofrekvenčni in visokozmogljivi energetski elektroniki se je postopoma pojavilo fizično ozko grlo polprevodniških naprav na osnovi silicija, polprevodniški materiali tretje generacije, ki jih predstavlja silicijev karbid (SiC), pa so postopoma postali industrializirani. Z vidika materialnih lastnosti ima silicijev karbid trikrat večjo širino pasovne reže kot silicijev material, desetkrat večjo kritično prebojno jakost električnega polja in trikrat večjo toplotno prevodnost, zato so silicijev karbidne energetske naprave primerne za visokofrekvenčne, visokotlačne, visokotemperaturne in druge aplikacije ter pomagajo izboljšati učinkovitost in gostoto moči energetskih elektronskih sistemov.
Trenutno so se na trg postopoma premaknile SiC diode in SiC MOSFET-i, obstajajo pa tudi bolj zreli izdelki, med katerimi se SiC diode na nekaterih področjih pogosto uporabljajo namesto silicijevih diod, ker nimajo prednosti povratnega polnjenja; SiC MOSFET se postopoma uporablja tudi v avtomobilski industriji, shranjevanju energije, polnilnih sistemih, fotovoltaiki in drugih področjih; na področju avtomobilskih aplikacij postaja trend modularizacije vse bolj izrazit, zato se mora za doseganje vrhunskih zmogljivosti SiC zanašati na napredne postopke pakiranja. Tehnično gledano je tesnjenje lupine relativno zrelo, kar je v prihodnosti bolj primerno za razvoj plastičnih tesnil, zato so njegove prilagojene značilnosti bolj primerne za SiC module.
Hitrost padca cen silicijevega karbida ali presega domišljijo

Uporaba naprav iz silicijevega karbida je v glavnem omejena zaradi visokih stroškov. Cena SiC MOSFET-a na isti ravni je štirikrat višja od cene Si IGBT-ja, kar je posledica kompleksnega postopka izdelave silicijevega karbida, pri katerem rast monokristalov in epitaksialnih vlaken ni le okoljsko škodljiva, temveč je tudi počasna, predelava monokristalov v substrat pa mora potekati skozi postopek rezanja in poliranja. Zaradi lastnosti materiala in nezrele tehnologije predelave je izkoristek domačega substrata manjši od 50 %, kar je posledica različnih dejavnikov, ki vodijo do visokih cen substratov in epitaksialnih vlaken.
Vendar pa je sestava stroškov naprav iz silicijevega karbida in naprav na osnovi silicija diametralno nasprotna, stroški substrata in epitaksialne plasti sprednjega kanala predstavljajo 47 % oziroma 23 % celotne naprave, kar skupaj znaša približno 70 %, stroški zasnove, izdelave in tesnjenja zadnjega kanala naprave predstavljajo le 30 %, proizvodni stroški naprav na osnovi silicija pa so v glavnem skoncentrirani na proizvodnjo rezin zadnjega kanala, približno 50 %, stroški substrata pa predstavljajo le 7 %. Pojav obrnjene vrednosti verige v industriji silicijevega karbida pomeni, da imajo proizvajalci epitaksialne plasti v zgornjem delu zgornjega dela glavne pravice do besede, kar je ključ do postavitve domačih in tujih podjetij.
Z dinamičnega vidika trga zmanjšanje stroškov silicijevega karbida poleg izboljšanja dolgih kristalov in postopka rezanja silicijevega karbida pomeni tudi povečanje velikosti rezin, kar je bila v preteklosti tudi zrela pot razvoja polprevodnikov. Podatki podjetja Wolfspeed kažejo, da se lahko z nadgradnjo substrata silicijevega karbida s 6 palcev na 8 palcev proizvodnja kvalificiranih čipov poveča za 80–90 % in izboljša izkoristek. Skupni stroški na enoto se lahko zmanjšajo za 50 %.
Leto 2023 je znano kot "prvo leto 8-palčnega SiC-ja". Letos domači in tuji proizvajalci silicijevega karbida pospešujejo postavitev 8-palčnih silicijevih karbidov. Wolfspeed je na primer vložil 14,55 milijarde ameriških dolarjev v širitev proizvodnje silicijevega karbida, pomemben del česar je gradnja obrata za proizvodnjo 8-palčnih SiC substratov. Da bi zagotovili prihodnjo dobavo 200 mm gole kovine SiC številnim podjetjem, sta Domestic Tianyue Advanced in Tianke Heda z Infineonom podpisala dolgoročne sporazume o dobavi 8-palčnih silicijevih karbidnih substratov v prihodnosti.
Podatki raziskave podjetja Ji Bond Consulting kažejo, da se bo silicijev karbid od letos naprej pospešil s 6 palcev na 8 palcev. Wolfspeed pričakuje, da se bodo stroški enote čipa 8-palčnega substrata do leta 2024 v primerjavi s stroški enote čipa 6-palčnega substrata v letu 2022 zmanjšali za več kot 60 %, znižanje stroškov pa bo še dodatno odprlo trg aplikacij. Trenutni tržni delež 8-palčnih izdelkov je manjši od 2 %, pričakuje pa se, da se bo do leta 2026 povečal na približno 15 %.
Pravzaprav lahko stopnja padanja cen silicijevega karbidnega substrata preseže domišljijo mnogih ljudi. Trenutna tržna ponudba 6-palčnega substrata je 4000–5000 juanov/kos, kar je v primerjavi z začetkom leta precej nižja cena in pričakuje se, da bo prihodnje leto padla pod 4000 juanov. Omeniti velja, da so nekateri proizvajalci, da bi si zagotovili prednost na trgu, znižali prodajno ceno na nižjo cenovno mejo. Odprl se je model cenovne vojne, ki je bil osredotočen predvsem na ponudbo silicijevega karbidnega substrata na področju nizke napetosti, domači in tuji proizvajalci pa agresivno širijo proizvodne zmogljivosti ali pa pustijo, da je ponudba silicijevega karbidnega substrata prej, kot si predstavljamo.
Čas objave: 19. januar 2024
